Warum Sie unsere Dienstleistungen benötigen, Sie wissen, dass Sie hochqualifizierte Fachleute bekommen, die über das Fachwissen und die Erfahrung verfügen, um sicherzustellen, dass Ihr Projekt ordnungsgemäß durchgeführt wird und funktioniert.

Dioden und Transistoren mit AlN-Kanälen liefern hohe Durchbruchspannungen und arbeiten bei unglaublich hohen Temperaturen.
Eine Reihe menschlicher Aktivitäten weiten sich auf extreme Umgebungen aus, oft motiviert durch die Ausbeutung von Ressourcen. Dies hat zu Erkundungen in verschiedene Richtungen geführt, darunter tief unter der Erde, in große Tiefen im Meer und in den Weltraum. In all diesen Umgebungen ist die Temperatur extrem – sie übersteigt 300 °C auf der Oberfläche der Venus, bei Tiefbrunnenbohrungen und im Raum innerhalb eines laufenden Motors.
Um mehr über all diese Umgebungen herauszufinden, ist der Einsatz von Sensoren erforderlich. Doch die naheliegendsten – also solche auf Siliziumbasis – sind dieser Aufgabe aufgrund einer relativ niedrigen Betriebstemperaturgrenze nicht gewachsen. Das bedeutet, dass wir Elektronik für extreme Temperaturen entwickeln müssen, um unser Leben in diesen Umgebungen zu bereichern.
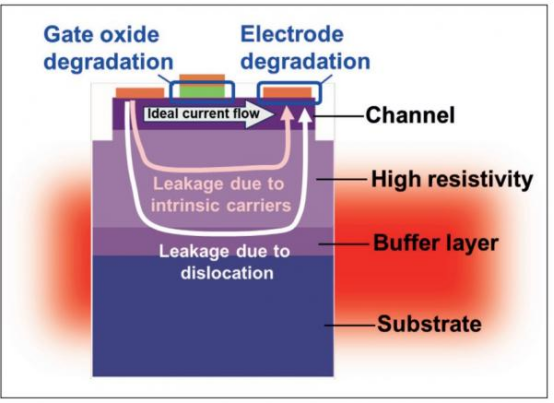
Abbildung 1. Der Leckstrompfad und die thermischen Degradationspunkte in einem MESFET mit Gateoxid.
Wenn alle Arten von Halbleiterbauelementen bei extremen Temperaturen betrieben werden, treten Probleme im Zusammenhang mit Materialien, Elektroden, Gate-Oxiden und Gehäusen auf (siehe Abbildung 1). Mit zunehmender Temperatur werden aufgrund der Anregung von Elektronen vom Valenzbandmaximum zum Leitungsbandminimum zahlreiche Elektron-Loch-Paare erzeugt. Diese Elektronen, die die intrinsische Trägerkonzentration erhöhen (siehe Abbildung 2 (a)), sind schädlich, da sie den Leckstrom der Geräte erhöhen und verhindern, dass sie sich ausschalten. Zu den Optionen zur Reduzierung des Leckstroms gehören die Einführung von Halbleitermaterialien mit einer größeren Bandlückenenergie und niedrigeren intrinsischen Ladungsträgerkonzentrationen (siehe Abbildung 2 (b)) oder die Einschränkung der Stromdiffusion aus anderen Bereichen als dem Kanal. Der Einsatz einer Kanalschicht, die von hochohmigen Schichten umgeben ist, die niedrige effektive Donor-/Akzeptorkonzentrationen und niedrige Defektkonzentrationen aufweisen, kann die Betriebstemperatur des Geräts erhöhen. Ein anderer Ansatz besteht darin, Geräte mit pn-Übergängen wie JFETs und BJTs einzusetzen. In diesen Fällen ist es auch wichtig, hochschmelzende Metalle für die Elektroden auszuwählen, die eine minimale Reaktivität mit unedlen Halbleitern aufweisen. Insbesondere Titan, Vanadium, Tantal, Molybdän, Wolfram und Platin eignen sich hierfür besser als Aluminium, Magnesium, Kupfer, Silber, Indium und Gold.
Warum AlN verwenden?
Es gibt viele Halbleitermaterialien mit einer größeren Bandlückenenergie als Silizium. Dazu gehören SiC (3,3 eV), GaN (3,4 eV), Ga2O3 (4,7–5,2 eV), Diamant (5,5 eV) und AlN (6,1 eV). Das Team der NASA unter der Leitung von Philip Neudeck hat berichtet, dass SiC-JFETs bei Temperaturen über 800 °C betrieben werden können. Während dies zweifellos ein beeindruckendes Ergebnis ist, versprechen Materialien mit noch größeren Bandlücken das Erreichen noch höherer Temperaturen. Allerdings weisen nicht wenige von ihnen erhebliche Nachteile auf. GaN leidet unter einer hohen effektiven Donorkonzentration von 1016 cm-3; Es ist nicht möglich, Ga vom p-Typ zu bilden2O3 Schichten; und Diamant beginnt bei etwa 700 °C mit Sauerstoff zu reagieren. Im krassen Gegensatz dazu weist AlN keine offensichtlichen Mängel auf und bietet thermische Stabilität und kontrollierbare Dotierung. Aufgrund dieser Eigenschaften hat unser Team an der Universität Tsukuba seine ganze Aufmerksamkeit AlN für die Entwicklung von Extremtemperaturgeräten gewidmet.
Historisch wurde angenommen, dass AlN nur als Isolator geeignet ist. Dass dies jedoch nicht der Fall ist, zeigten Yoshitaka Taniyasu und Kollegen von NTT vor etwa 20 Jahren, indem sie mittels MOCVD elektrisch leitfähige AlN-Schichten aufwachsen ließen.
Dieses Team verzeichnete eine Elektronenmobilität von 426 cm2 V-1 s-1 für Silizium-dotierte AlN-Schichten, für eine Dotierstoffkonzentration von 3 x 1017 cm-3. Aufbauend auf dieser Arbeit leisteten sie Pionierarbeit beim p-Typ-AlN-Wachstum und demonstrierten die ersten AlN-LEDs mit einer Wellenlänge von 210 nm und quasi-vertikalen AlN-pn-Dioden. Diese Erfolge sind der jüngsten, rasanten Entwicklung von Tief-UV-LEDs auf Basis von AlGaN und AlN zu verdanken.
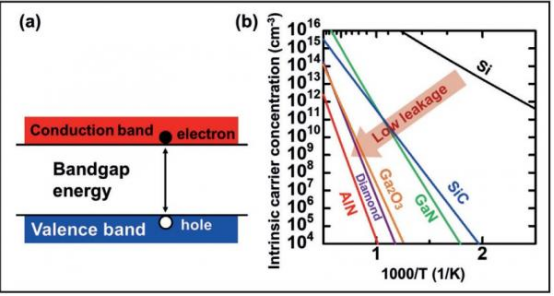
Abbildung 2. (a) Eine Darstellung der Erzeugung von Elektron-Loch-Paaren bei hohen Temperaturen. (b) Die intrinsische Trägerkonzentration von Silizium, SiC, GaN, β-Ga2O3-Diamant und AlN als Funktion der reziproken Temperatur.
Neben optischen Geräten hat die Forschungsgemeinschaft auch AlN-Schottky-Barrieredioden und AlN/AlGaN-HEMTs untersucht, um die potenziellen Vorteile eines hochkritischen elektrischen Felds zu erkunden. Leider weisen diese Geräte aufgrund der hohen Ionisierungsenergien der Donatoren und Akzeptoren eine niedrige Trägerkonzentration auf – sie beträgt 0,3 eV für Silizium und 0,6 eV für Magnesium. Aus diesem Grund sind die Trägerkonzentrationen dieser beiden Dotierstoffe etwa zwei Größenordnungen niedriger als ihre Konzentrationen, was dazu führt, dass Geräte sehr kleine Ströme haben. Um dieses Problem zu lösen, hat unser Team in Zusammenarbeit mit Forschern des MIT und der Aalto-Universität neue Wege beschritten, indem es eine polarisationsinduzierte Dotierung in N-polaren AlGaN/AlN-Strukturen eingeführt hat. Dank spontaner und piezoelektrischer Polarisationen kann diese Form der Dotierung den Strom erhöhen und den Kontaktwiderstand verringern. Mithilfe polarisationsinduzierter Dotierung haben wir die ersten N-polaren PolFETs und HEMTs auf AlN-Basis mit Drainströmen über 100 mA mm-1 demonstriert. Dieser Erfolg hat uns dazu veranlasst, AlN als praktischen Halbleiter für optische und elektrische Geräte zu betrachten.
Zur Herstellung dieser Geräte konnten wir auf eine Reihe von Materiallieferanten zurückgreifen. Hochwertige AlN-Proben auf 2-Zoll-Saphirsubstraten können bei Dowa Electronics Materials erworben werden, und 2-Zoll-Massen-AlN ist im Handel bei Stanley und Asahi Kasei erhältlich.

Abbildung 3. (a) Tiefenprofile der Verunreinigungskonzentration von Silizium, Sauerstoff und Kohlenstoff in einer 3 µm dicken siliziumimplantierten AlN-Schicht nach dem Tempern bei 1600 °C. (b) Tiefenprofile der Magnesiumkonzentration in einer 1 µm dicken, mit Magnesium implantierten AlN-Schicht nach dem Tempern.
AlN dotieren
Die Konzentration von Dotierstoffen in Halbleitern wird durch den Einbau von Verunreinigungen während des Kristallwachstums sowie durch thermische Diffusion und möglicherweise Implantation gesteuert. Letzteres ist eine attraktive Technologie, die eine präzise Dosissteuerung ermöglicht und eine hohe laterale Gleichmäßigkeit des Dotierstoffs gewährleistet. Wenn jedoch hochdosierte Implantationen eingesetzt werden, neigen sie dazu, Kristallgitter zu beschädigen und hohe Konzentrationen von Punktdefekten einzuführen, die Ladungsträger kompensieren können. Glücklicherweise können die meisten dieser Schäden durch postthermisches Ausheilen repariert werden, das wir bei der Herstellung eines siliziumimplantierten n-Typ-AlN-Kanals verwendet haben.
Eine der beeindruckenden Eigenschaften von AlN-Kristallen, einschließlich ihrer Oberflächen, ist ihre Robustheit bei erhöhten Temperaturen mit Stabilität unter Stickstoffgas bei bis zu 1700 °C. Diese Robustheit bietet ein breites Fenster zur Reparatur von Implantationsschäden – dieser Prozess erfordert Temperaturen über 1200 °C für die elektrische Aktivierung der siliziumimplantierten AlN-Schicht. Beachten Sie jedoch, dass bei der Auswahl der Glühtemperatur viel Überlegung erforderlich ist, da diese andere Veränderungen im Material hervorrufen kann. Ab 1400 °C diffundieren Silizium- und Sauerstoffverunreinigungen in die darüber liegende Schicht. Aufgrund der Diffusion von Sauerstoffatomen aus dem Saphirsubstrat, das sich bei 1500 °C unter Stickstoffgas zersetzt, weist eine dünne AlN-Schicht auf einem Saphirsubstrat nach dem Hochtemperaturglühen eine hohe Sauerstoffkonzentration auf, was zu einer Verschlechterung der elektrischen Eigenschaften führt.
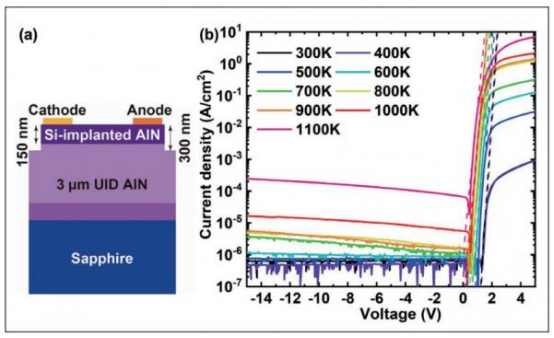
Abbildung 4. (a) Der Querschnitt einer Schottky-Barrierediode mit einem siliziumimplantierten AlN-Kanal. Ni/Au-Anode und Ti/Al/Ti/Au-Kathode. (b) Stromdichte-Spannungs-Kennlinien einer AlN-Schottky-Diode von 27 °C bis 827 °C.
In Zusammenarbeit mit MIT, Aalto University, TNSC und Dowa Electronics Materials haben wir die Diffusion von Silizium-, Sauerstoff- und Magnesiumatomen in AlN untersucht (siehe Abbildung 3). Unsere Untersuchungen ergaben, dass aus einem Saphirsubstrat diffundierende Sauerstoffatome nach dem Tempern unter Verwendung von 3 µm dicken AlN-Schichten die Kanalschicht nicht erreichen können. Dies führte uns zu dem Schluss, dass die bevorzugten Glühtemperaturbereiche für elektrisch leitfähige AlN-Schichten mit Silizium- und Magnesiumimplantaten 1200–1600 °C bzw. 1400–1500 °C betragen. Dieses Wissen ermöglichte es uns, die ersten AlN-Kanal-Transistoren zu demonstrieren.
Wenn bei der Herstellung von Bauelementen Bedingungen nahe am thermischen Gleichgewicht erforderlich sind, wie etwa epitaktisches Wachstum und Hochtemperaturglühen, wird die Bildung tiefer Zustände mit Ionisierungsenergien von 250–320 meV begünstigt. Dies führt tendenziell zur Selbstkompensation des Siliziumspenders, eine Situation, die mit unseren Ergebnissen übereinstimmt.
Mittlerweile ermöglicht der Einsatz von Nichtgleichgewichtsprozessen, wie etwa der Ionenimplantation, eine Vergrößerung der Population flacher Donatoren mit Ionisierungsenergien von 64–86 meV. Dies veranlasste Hayden Breckenridge und Kollegen von der University of North Carolina und Adroit Materials dazu, durch Siliziumimplantation und Nachglühen bei einer relativ niedrigen Temperatur von 1200 °C eine hochleitfähige AlN-Schicht herzustellen. Ein weiteres ermutigendes Ergebnis der Universität Kyoto ist, dass die substitutionelle Magnesium-Akzeptor-Bindungsenergie von AlN nur 250–410 meV beträgt, ein Wert, der viel kleiner ist als die Ionisierungsenergie von Magnesium-Akzeptoren in herkömmlichen MOCVD-gewachsenen AlN-Schichten. Zusammenfassend deuten diese Ergebnisse darauf hin, dass, wenn Nichtgleichgewichtsprozessbedingungen in AlN, das mit Silizium und Magnesium dotiert ist, reproduzierbar und einfach kontrolliert werden können, dies die Tür zu elektronischen und optischen Geräten mit deutlich verbesserter Leistung öffnen könnte.
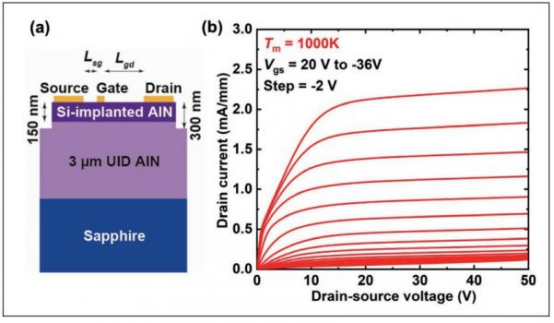
Abbildung 5. (a) Schematischer Querschnitt eines MESFET mit einem siliziumimplantierten AlN-Kanal. (b) DC-Ausgangseigenschaften eines AlN-MESFET bei 727 °C.
Elektrische Eigenschaften von AlN
Um die elektrische Leistung von AlN-basierten Geräten zu verbessern, muss mehr getan werden, als nur den hohen spezifischen Widerstand von AlN-Schichten vom n-Typ und p-Typ anzugehen, der durch niedrige Ladungsträgerkonzentrationen beeinträchtigt wird. Darüber hinaus muss der hohe Kontaktwiderstand, der aus der geringen Elektronenaffinität resultiert, angegangen werden.
Besonders schwierig ist es, in AlN bei Raumtemperatur einen ohmschen Kontakt herzustellen. Der Spannungsabfall wird durch die Höhe der Schottky-Barriere bestimmt, die von der Differenz zwischen der Metallaustrittsarbeit und der Elektronenaffinität des Halbleiters abhängt. Es ist möglich, ohmsche Kontakte herzustellen, indem die Höhe der Potentialbarriere durch geeignete Auswahl der Elektrodenmaterialien gesenkt wird. Optionen für AlN vom n-Typ sind Titan, Aluminium, Vanadium und Molybdän, während ohmsche Kontakte zu AlN vom p-Typ Palladium und NiO verwenden können.
Eine Folge starker Dotierung in Halbleitermaterialien ist eine Verringerung der Breite des Verarmungsbereichs, was zum Tunneln durch Potentialbarrieren führt. Die starke Dotierung der obersten AlN-Oberfläche ist für ohmsche Kontakte sehr wichtig. Da die Konzentration der Silizium- und Magnesium-Dotierstoffe in AlN-Schichten jedoch auf etwa 10 begrenzt ist19 cm-3Möglicherweise aufgrund der Bildung von Kompensationsdefekten besteht keine Aussicht auf einen Feldemissionstunnelbau.
Um die Ladungsträgerkonzentration und Ladungsträgermobilität in Halbleiterstrukturen zu bestimmen, greifen Forscher häufig auf Hall-Effekt-Messungen zurück. Da für diese Messungen ohmsches Verhalten erforderlich ist, wurden in einigen Studien stark dotierte GaN-Kontaktschichten verwendet. Dies ermöglichte die Bestimmung der elektrischen Eigenschaften von AlN, sowohl bei Raumtemperatur als auch bei erhöhten Temperaturen. Zusammen mit anderen haben wir die Ladungsträgerkonzentration und Ladungsträgermobilität bei hohen Temperaturen bewertet und dabei Werte für n-Typ- und p-Typ-AlN bei Temperaturen über 200 °C bzw. 500 °C erhalten.
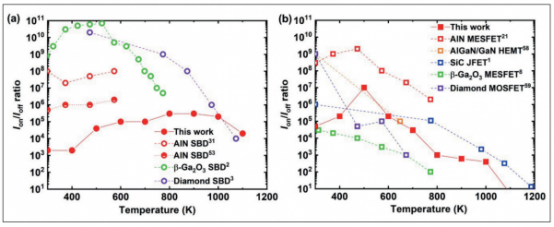
Abbildung 6. Ein Benchmarking-Diagramm, das das Strom-Ein/Aus-Verhältnis mit der Messtemperatur von AlN-Geräten mit den anderen hochmodernen (a) Schottky-Dioden und (b) FETs vergleicht.
Bei der Durchführung dieser Studie haben wir ein neues Problem im Zusammenhang mit Hochtemperaturmessungen entdeckt. Wir mussten eine Sondenstation verwenden, da uns Verbindungs- und Gehäusetechnologien für extreme Temperaturen fehlten. Wir haben auch festgestellt, dass normale Sondenspitzen bei hohen Temperaturen beschädigt werden. Beachten Sie, dass die meisten gemeldeten Geräte eine maximale Betriebstemperatur von nicht mehr als 500 °C haben, was bedeutet, dass Messungen der elektrischen Eigenschaften bei höheren Temperaturen unzuverlässig sind.
In Zusammenarbeit mit Dowa Electronics Materials haben wir die elektrischen Eigenschaften von 3 µm dicken AlN-Schichten auf Saphirsubstraten mit einem Hochtemperatur-Sondensystem bewertet, das eine maximale Messtemperatur von 900 °C im Hochvakuum bietet. Zu diesem Zweck haben wir bei Raumtemperatur Silizium in die AlN-Schicht implantiert, um eine n-Leitfähigkeit zu erhalten. die Konzentration betrug 2 × 1019 cm-3 in einem 150 nm tiefen Kastenprofil. Diese mit Silizium implantierten AlN-Schichten wurden anschließend bei 1500 °C getempert. Anschließend haben wir Ti/Al/Ti/Au-Elektroden für ohmsche Kontakte abgeschieden, bevor wir bei 950 °C gesintert haben.
Unsere Elektroden verschlechterten sich bei 877 °C, möglicherweise aufgrund einer Reaktion zwischen Ti/Al und AlN. Dies veranlasste uns, nach geeigneten Metallen für ohmsche Kontakte bei extremen Temperaturen zu suchen. Für die Temperaturen, die wir berücksichtigen konnten, beobachteten wir eine Strom-Spannungs-Beziehung, die unter 127 °C nichtlinear und über 227 °C nahezu linear ist. Die Bewertung der elektrischen Eigenschaften zwischen 227 °C und 827 °C ergab, dass der Schichtwiderstand und der Kontaktwiderstand mit steigender Temperatur abnahmen. Von 227 °C auf 627 °C nahm die Elektronenmobilität mit zunehmender Temperatur leicht ab, aber die Elektronenkonzentration stieg aufgrund der verstärkten Donatorionisierung an, was zu einer Verringerung des Schichtwiderstands bei hohen Temperaturen führte. Dies führte uns zu dem Schluss, dass n-Typ-AlN-Schichten bei extremen Temperaturen eine hervorragende Leistung zeigen.
Dioden und Transistoren
Wir haben Schottky-Barrieredioden und MESFETs mit siliziumimplantierten AlN-Schichten auf Saphirsubstraten hergestellt. Unsere Dioden können bei 827 °C betrieben werden (siehe Abbildung 4) und übertreffen damit alle bisherigen Rekorde, während unsere Transistoren bei bis zu 727 °C betrieben werden können (siehe Abbildung 5). Die AlN-Schottky-Barrierendioden haben bei Raumtemperatur eine Durchbruchspannung von 610 V, während der entsprechende Wert für die AlN-MESFETs bei 727 °C bei 176 V liegt. Wir möchten darauf hinweisen, dass diese Geräte praktisch machbar sind, da sie einen einfachen Aufbau haben Struktur, und die AlN-Schichten werden auf großen, kostengünstigen Saphirsubstraten aufgewachsen.
Zur Herstellung unserer Schottky-Barrierendioden und MESFETs haben wir Ni/Au für die Anoden- und Gate-Kontakte verwendet. Wir haben festgestellt, dass Nickel thermisch stabil ist und selbst bei 827 °C kaum mit AlN reagiert. Darüber hinaus konnten wir hinsichtlich der elektrischen Eigenschaften kaum Unterschiede zwischen Ni/Au und Pt/Au feststellen. Bei der Schottky-Barrierediode ist der Sperrstrom aufgrund der geringen intrinsischen Ladungsträgerkonzentration und der thermisch stabilen Ni/AlN-Grenzfläche selbst bei 827 °C gering. Allerdings ist der Drain-Strom im ausgeschalteten Zustand des AlN-MESFET bei 727 °C hoch, was auf den Leckstrom durch die unteren undotierten AlN-Schichten und die hohe Konzentration von Defekten zurückzuführen ist. Im Gegensatz zum Strom in Siliziumbauelementen, der bei hohen Temperaturen aufgrund der Phononenstreuung abnimmt, haben wir herausgefunden, dass der Durchlassstrom von AlN-Schottky-Barrierendioden und MESFETs mit der Temperatur bis zu 827 °C weiter ansteigt. Wir führen dies darauf zurück, dass der Strom in AlN-Geräten bei extremen Temperaturen durch die Erhöhung der Elektronenkonzentration und die Verringerung des Kontaktwiderstands dominiert wird, wobei die Verringerung der Elektronenmobilität eine untergeordnete Rolle spielt.
Unsere Entwicklung von AlN-Geräten ebnet einen neuen Weg zur Herstellung von Halbleitergeräten, die bei extremen Temperaturen betrieben werden können. Obwohl zwischen dem Ein-Aus-Verhältnis und der Temperatur von Schottky-Barrierendioden und FETs ein Kompromiss besteht (siehe Abbildung 6), besteht bei AlN-Bauelementen großes Verbesserungspotenzial. Beispielsweise sollte es möglich sein, das An/Aus-Verhältnis bei extremen Temperaturen durch eine Kombination aus homoepitaktischem Wachstum und der Einführung einer JFET-Struktur zu erhöhen. Weitere Verbesserungen könnten durch die Einführung hitzebeständiger ohmscher Kontakte anstelle von Ti/Al/Ti/Au entstehen, was die Betriebstemperatur auf über 877 °C erhöhen würde.
Für die meisten Anwendungen bei extremen Temperaturen müssen ICs über lange Zeiträume zuverlässig funktionieren. Solche Schaltkreise werden mit komplementärer Technologie mit n- und p-Kanälen hergestellt. An der Universität Kyoto haben Ingenieure ein SiC-komplementäres JFET-Logikgatter entwickelt, das bei 350 °C arbeitet. Wir hoffen, unsere Arbeit in eine ähnliche Richtung zu lenken und komplementäre JFETs mit homoepitaxialen AlN-Kanälen herzustellen, die in extremen Umgebungen betrieben werden können.
VON HIRONORI OKUMURA VON DER UNIVERSITÄT TSUKUBA
aus https://compoundsemiconductor.net/article/118570/Extreme-temperature_devices_using_AlN
Warum Sie unsere Dienstleistungen benötigen, Sie wissen, dass Sie hochqualifizierte Fachleute bekommen, die über das Fachwissen und die Erfahrung verfügen, um sicherzustellen, dass Ihr Projekt ordnungsgemäß durchgeführt wird und funktioniert.
Wenn Sie eine kostenlose Beratung wünschen, beginnen Sie bitte mit dem Ausfüllen des Formulars:
Erhalten Sie Verkaufsinformationen, Neuigkeiten und Updates in Ihrem Posteingang.
 闽ICP备19012761号-1
闽ICP备19012761号-1



